MEMS,有望成为中国半导体的突破口
来源:https://www.ssrt.com.cn
|
作者:SSRT
|
发布时间 :2025-04-18
|
61 次浏览:
|
分享到:
MEMS传感器的主要构造?MEMS芯片与集成电路芯片有什么区别?
MEMS是Micro-Electro-MechanicalSystem的缩写,中文名称是微机电系统,是将微电子电路技术与微机械系统融合到一起的一种工业技术,它的操作范围在微米尺度内。此外还有纳米机电系统( NEMS ) ,是一类在更微小的纳米尺度上集成电气和机械功能的设备,NEMS技术目前在量产和商业化上仍存在一些挑战。
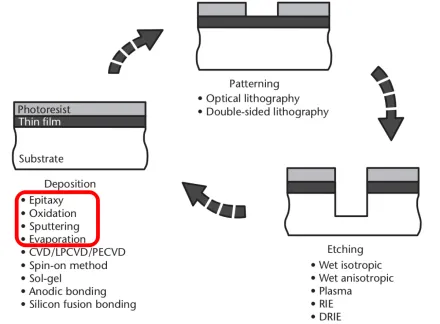
MEMS工艺以成膜工序、光刻工序、蚀刻工序、键合工序等常规半导体工艺流程为基础。除通用工艺外,由于MEMS器件结构的特殊性,也衍生出许多特殊制造工艺。
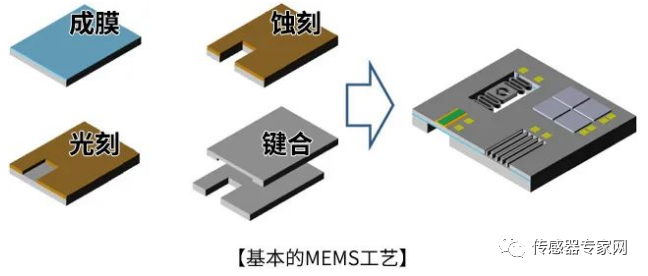
MEMS工艺以成膜工序、光刻工序、蚀刻工序、键合工序等常规半导体工艺流程为基础。除通用工艺外,由于MEMS器件结构的特殊性,也衍生出许多特殊制造工艺。
SOI晶圆
SOI是Silicon On Insulator的缩写,是指在氧化膜上形成了单晶硅层的硅晶圆。已广泛应用于功率元件和MEMS等,在MEMS中可以使用氧化膜层作为硅蚀刻的阻挡层,因此能够形成复杂的三维立体结构。
晶圆粘合/热剥离片工艺
通过使用支撑晶圆和热剥离片,可以轻松对薄化晶圆进行处理等。
晶圆键合
对于MEMS器件与CMOS 芯片的高度集成,以及许多MEMS都是基于SOI晶圆等技术基板,这些需求都严重依赖晶圆键合这一重要工艺。
所谓晶圆键合工艺,是指在一定外部条件(温度、压力、电压等)的作用下,使两个衬底材料(如硅-硅或硅-玻璃等)形成足够的接触,最终通过相邻材料的界面之间形成的分子键作用力或化学键,将两个衬底材料结合为一体的技术。目前晶圆键合工艺技术可分为两大类:一类是键合双方不需要介质层的直接键合,例如Si-Si键合;另一类是需要介质层的中间材料键合,例如聚合物键合。
晶圆键合大致分为“直接键合”、“通过中间层键合”2类。
直接键合不使用粘合剂等,是利用热处理产生的分子间力使晶圆相互粘合的键合,用于制作SOI晶圆等。
通过中间层键合是借助粘合剂等使晶圆互相粘合的键合方法。

MEMS芯片三种制造工艺
MEMS制造工艺主要包括表面微加工技术、体微加工技术、LIGA技术等,目前应用范围最广、技术最成熟的为前两者。
体微加工(Bulk Micromachining)是指将硅衬底自上而下地进行刻蚀的工艺,是一种通过各向异性或各向同性刻蚀衬底的方法在硅衬底上制造各种机械结构器件的技术,包括湿法刻蚀和干法刻蚀,是制备具有立体结构的MEMS器件的重要方法。其特点是设备简单、投资少,但只能做形状简单的器件,深宽比小的器件。是通过对硅材料的腐蚀得到的,消耗硅材料较多(有时称作减法工艺),而且只能以硅材料为加工对象。
表面微加工(Surface Micromachining)是利用薄膜沉积、光刻、刻蚀等方法,通过将材料逐层添加在基底上,用表面生长方法及光刻法在表面制造各种微型机械结构器件,最后去除牺牲层从而构造微结构。在衬底顶面沉积和刻蚀如金属、多晶硅、氮化物、氧化物、有机材料等。